

-
首页
-
产品中心
- 光学加工
- 无掩模版紫外光刻机
- 超高精度3D光刻设备
- 光学检测
- 3D显微镜/轮廓仪
- 光电分析设备
- 磁学分析设备
- 加工服务及耗材
- 代加工服务
- 3D光刻材料
- 光刻胶及配套试剂
- 更多产品
- 超低温恒温器
- 激光器
- 光学平台
- 电输运接线盒
- 显微物镜
-
技术百科
-
客户案例
-
新闻中心
-
关于我们
- 公司简介
- 技术支持
- 在线留言
- 联系我们


-
首页
-
产品中心
- 光学加工
- 无掩模版紫外光刻机
- 超高精度3D光刻设备
- 光学检测
- 3D显微镜/轮廓仪
- 光电分析设备
- 磁学分析设备
- 加工服务及耗材
- 代加工服务
- 3D光刻材料
- 光刻胶及配套试剂
- 更多产品
- 超低温恒温器
- 激光器
- 光学平台
- 电输运接线盒
- 显微物镜
-
技术百科
-
客户案例
-
新闻中心
-
关于我们
- 公司简介
- 技术支持
- 在线留言
- 联系我们
紫外光刻工艺流程
紫外光刻是指紫外光源对光刻胶进行空间选择性曝光,进而将所设计好的图形转移到硅片上的技术。
光刻是一个复杂的物理化学过程,具有大面积、易操作、可量产和低成本等特点,是半导体器件与大规模集成电路制造的核心步骤。

01 衬底预处理(Substrate Pre-treatment):
当使用新的洁净衬底时,需要预先在热板上加热(150~200℃,2~3分钟),以去除衬底表面的水汽,并且应该尽快进行下一步工艺,或者将已经处理好的衬底存放在干燥容器中避免再次吸收水分。对于被污染的衬底或是使用过的晶圆,需要进行彻底的清洗。常规清洁步骤是先用丙酮处理,然后使用异丙醇或者乙醇清洗,最后进行干燥处理,从而提高衬底对光刻胶的粘附力。
02 涂胶(Coat):
光刻胶主要通过旋涂的方式进行涂布,对于薄胶,最佳的旋涂转速为2000~4000rpm,对于相对较厚的胶,最佳旋涂转速为250~2000rpm,匀胶机的转速通常可以达到9000rpm,在某些情况下,还可以使用100~200rpm这类较慢的转速来获得特定较厚的胶层。但是这种情况下,胶膜的质量会下降,并且可能会在硅片的边缘形成大量的边缘胶珠,可以通过旋涂获得30~200μm的胶厚(取决于光刻胶的类型),也可以使用自流平的方法获得高达1mm的厚胶膜。
S1800系列的光刻胶是常用的薄胶,稳定可靠。如下图所示:以S1811光刻胶为例,在5000rpm下胶厚约为 1.0μm,在2000rpm下的胶厚约为1.5μm,使用高转速(6000rpm)可将胶厚控制在0.8μm左右。

托托科技(苏州)有限公司对S1805光刻胶已有成熟的工艺参数,在前转500rmp/s;后转5000rpm/s 50s参数下能获得最合适的曝光效果;可应用于湿法腐蚀和干法刻蚀,也可与底层胶 LOR搭配,做lift-off 工艺。
03 前烘(Soft bake):
前烘的目的是将光刻胶的有机溶剂挥发掉,使胶的表面固化。每种光刻胶都有特定的前烘温度与时间,前烘结束后要等待硅片冷却才能进行下一步工艺。
04 曝光(Exposure):
曝光时,硅片表面的光刻胶与紫外光会发生化学反应。在托托科技的无掩模光刻设备中,由所选图形产生二进制信号控制微反射镜的偏转角度,使得紫外光的空间分布与待光刻区域一致,以此达到所见即所得的光刻效果。
曝光时间和光强共同决定光刻效果,若曝光时间过短或者光强过小,则会曝光不足,在结果上表现为显影后的图样为彩色或显示不完整,如图1所示;
若曝光时间过长或者光强过大,则会产生过曝现象,会导致图形线宽增加或边缘出现锯齿,如图3所示。
不同的光刻胶有不同的最佳曝光时间与光强,可以通过软件中的阵列光刻模式来寻找最佳曝光参数。

图1 曝光时间过短或光强过小

图2 曝光正常
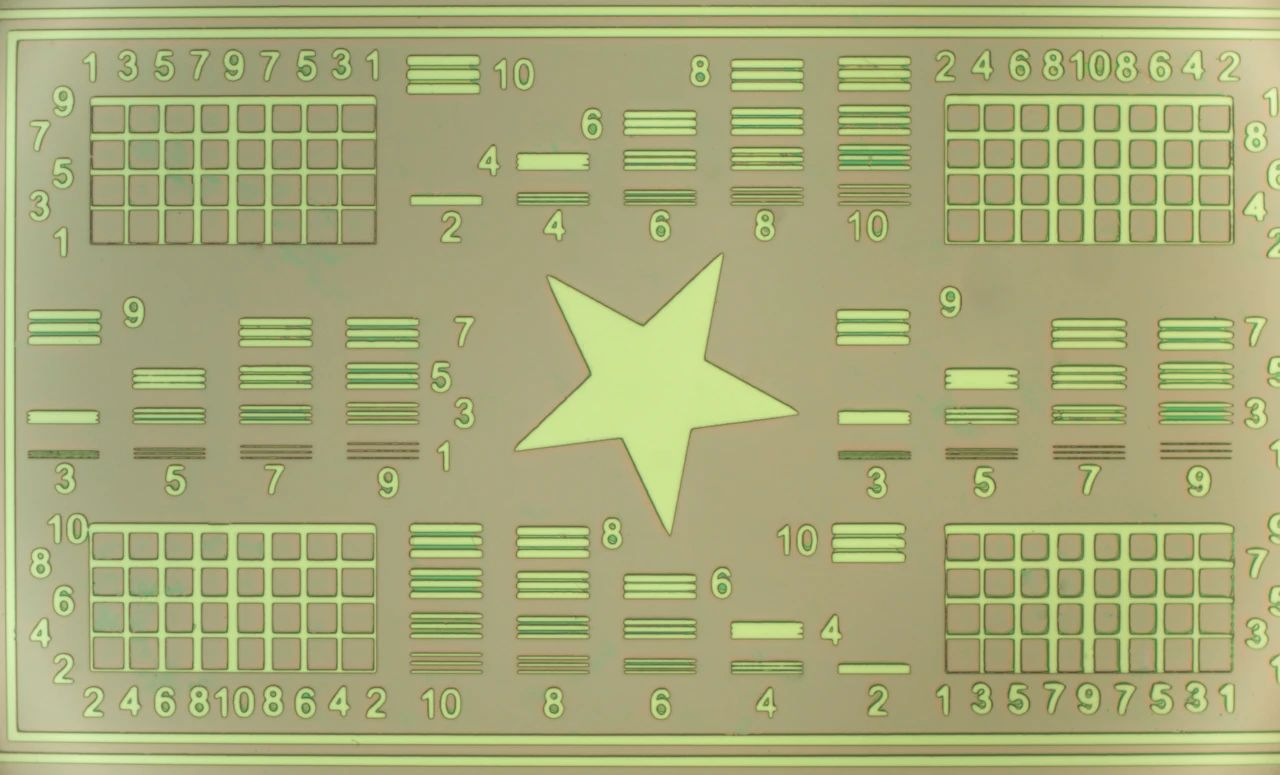
图3 曝光时间过长或光强太大
05 显影(development):
光刻分为正性光刻和负性光刻两种基本工艺,区别在于两者使用的光刻胶类型不同。正胶的曝光区域被破坏,可溶于显影液,其它区域不溶于显影液。负胶曝光区域由于交联反应不溶于显影液,其它区域可溶。不同的光刻胶对应不同的显影液与显影时间,当显影液使用次数过多、长时间暴露在空气中或者同一硅片多次显影都会对显影结果产生影响。

06 坚膜(hard bake):
坚膜就是通过加温烘烤使膜更加牢固地粘附在硅片表面,并增加胶层的抗刻蚀能力。坚膜并不是一道必须工艺,如后续有刻蚀工艺,建议进行坚膜,以此来提高光刻胶的稳定性。
07 去胶(remove):
去胶的方法通常有湿法和干法两种。湿法就是利用有机溶剂或者对光刻胶有腐蚀作用的溶液将光刻胶溶解或者腐蚀掉,从而达到去胶的目的。干法去胶是利用氧等离子体将光刻胶灰化掉,从而达到去胶的目的。
托托科技是一家快速成长的技术驱动型企业,专注于光学显微加工及光学显微检测的光学仪器设备制造。其无掩模版紫外光刻机,通过数字化方式,将图案加载于DMD(数字微镜器件)上,光刻图案设计灵活,具有高稳定性、高分辨率和高套刻精度等众多优点,为微纳器件的结构设计提供更多的可能性。
