

-
首页
-
产品中心
- 光学加工
- 无掩模版紫外光刻机
- 超高精度3D光刻设备
- 光学检测
- 3D显微镜/轮廓仪
- 光电分析设备
- 磁学分析设备
- 加工服务及耗材
- 代加工服务
- 3D光刻材料
- 光刻胶及配套试剂
- 更多产品
- 超低温恒温器
- 激光器
- 光学平台
- 电输运接线盒
- 显微物镜
-
技术百科
-
客户案例
-
新闻中心
-
关于我们
- 公司简介
- 技术支持
- 在线留言
- 联系我们


-
首页
-
产品中心
- 光学加工
- 无掩模版紫外光刻机
- 超高精度3D光刻设备
- 光学检测
- 3D显微镜/轮廓仪
- 光电分析设备
- 磁学分析设备
- 加工服务及耗材
- 代加工服务
- 3D光刻材料
- 光刻胶及配套试剂
- 更多产品
- 超低温恒温器
- 激光器
- 光学平台
- 电输运接线盒
- 显微物镜
-
技术百科
-
客户案例
-
新闻中心
-
关于我们
- 公司简介
- 技术支持
- 在线留言
- 联系我们
光学临近效应修正技术
OPC技术简介
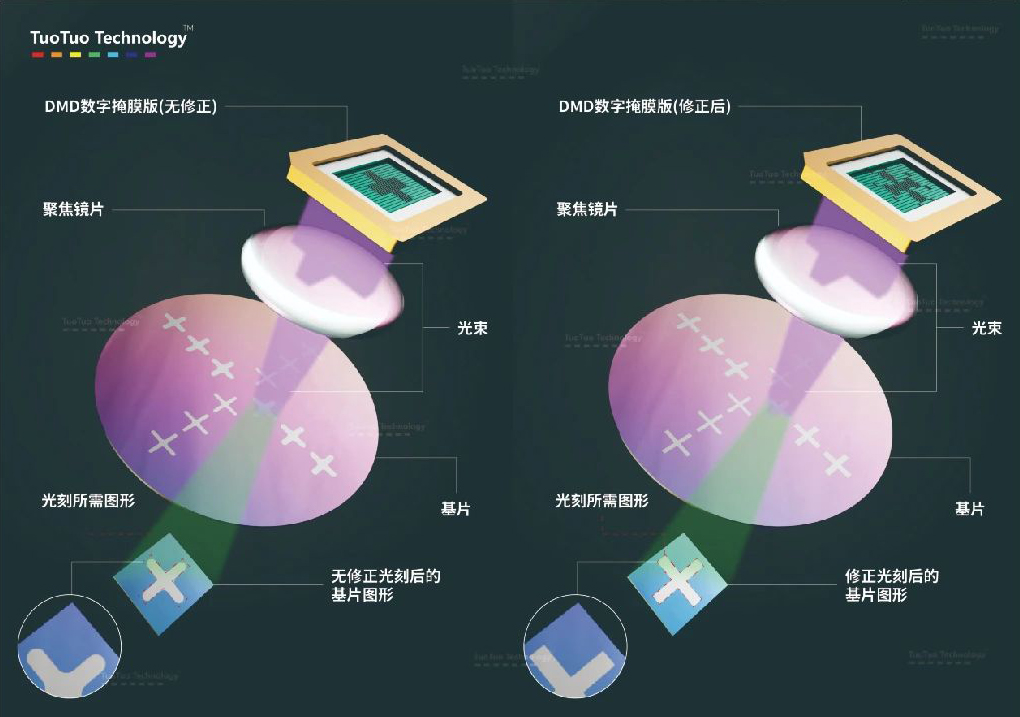
图 1 OPC技术示意图
托托科技的无掩模光刻设备内嵌了光学临近效应修正技术
在半导体制造技术中,光刻是一种对紫外敏感的光刻胶进行空间选择性曝光的技术。不过,由于物理限制(如衍射效应和光学影像形变等),光刻所得到的图形产生圆角及失真,无法制备出与设计完全相符的图形样品。这就需要使用光学邻近效应修正(Optical Proximity Correction,OPC)技术,以确保光刻图案的可靠性和精确性。
那什么是OPC技术呢?它是一种应用于半导体光刻中的核心技术,通过调整在掩模上透光区域图形的拓扑结构,或者在掩模上添加细小的亚分辨辅助图形,使得光刻成像结果尽量接近设计图形。OPC技术广泛应用于半导体芯片、微流控、传感器、超材料、生物医疗微器件、微流体和微光子与光子学等光刻图形的细节修正。
越是精密的图形(线宽尺度接近光学衍射极限),OPC技术就愈重要,比如在2023年,英伟达在GTC上宣布了一项名为CuLitho的新技术,其中就有一个重要的应用是光刻版图的OPC修正,利用强大的算力,使得原先需要两周的运算量,缩短为8小时,极大地推进了5 nm及更高制程的研发进度。
OPC技术的实现方法有两种,基于规则的rule based OPC(RB-OPC)和基于模型的model based OPC(MB-OPC)。RB-OPC是预先建立图形修正的规则库,然后通过查表来修正掩模图形。MB-OPC是利用光刻成像模型(包括光学模型和光刻胶模型),对OPC问题建模并将其转化为数学优化问题,结合算法优化出掩模的结构和图形。

图 2黄仁勋发布最新的AI运算单元(图源网络)
托托科技OPC技术结果展示
托托科技的光刻设备通过近紫外的光(355-405nm),实现百纳米级精度的光刻,由此产生OPC技术的需求。通过托托科技软件内嵌的OPC技术,客户可以轻松实现更高品质的光刻作业。
以下图片的左侧为修正前初始光刻掩模结构及其光刻结果,掩模图形分布与设计结果一致,但是由于光学临近效应的存在,图形与设计目标偏差较大。右侧为托托科技利用OPC技术修正后的光刻结果,图形的失真问题得到了明显改善,与设计结构已十分的接近。
图中可见,图形的内外角明显变得更锐利,拥有与设计图更高的契合度。
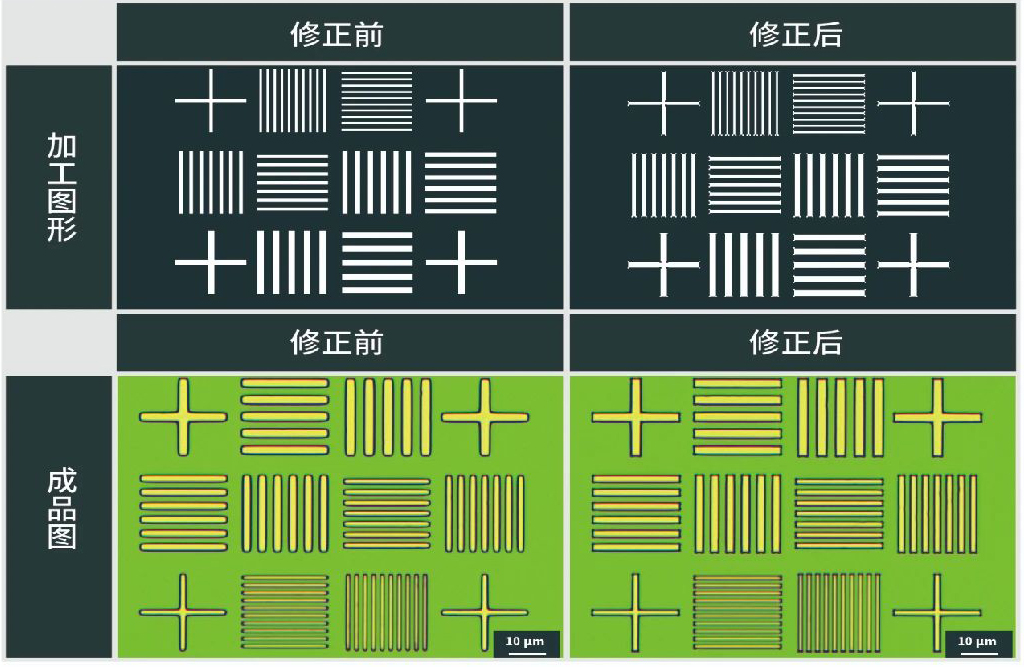
图 3 组合图形(内外角)修正结果

图 4 十字图案(内外角)修正结果
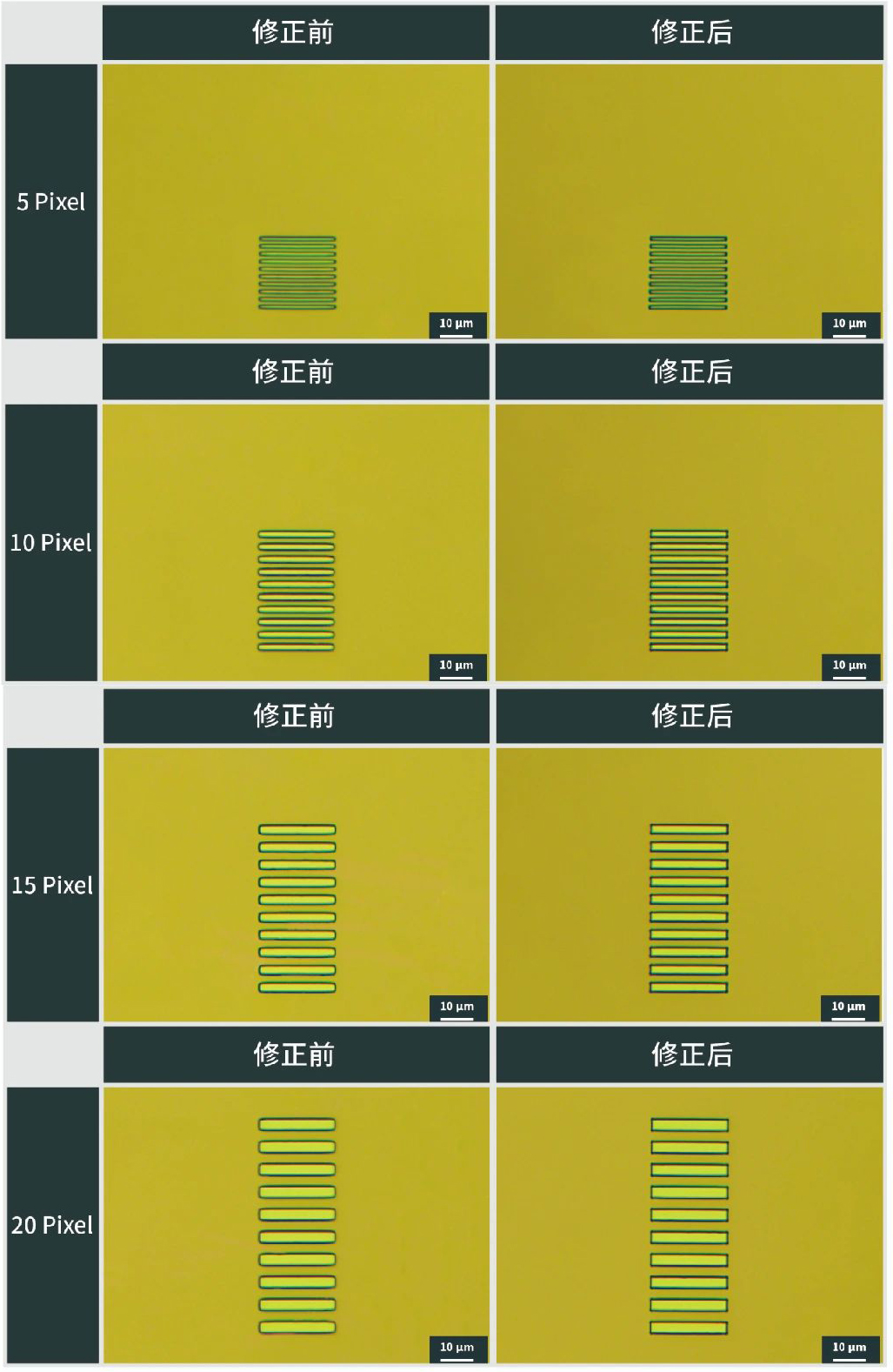
图 5 光栅(外角)修正结果
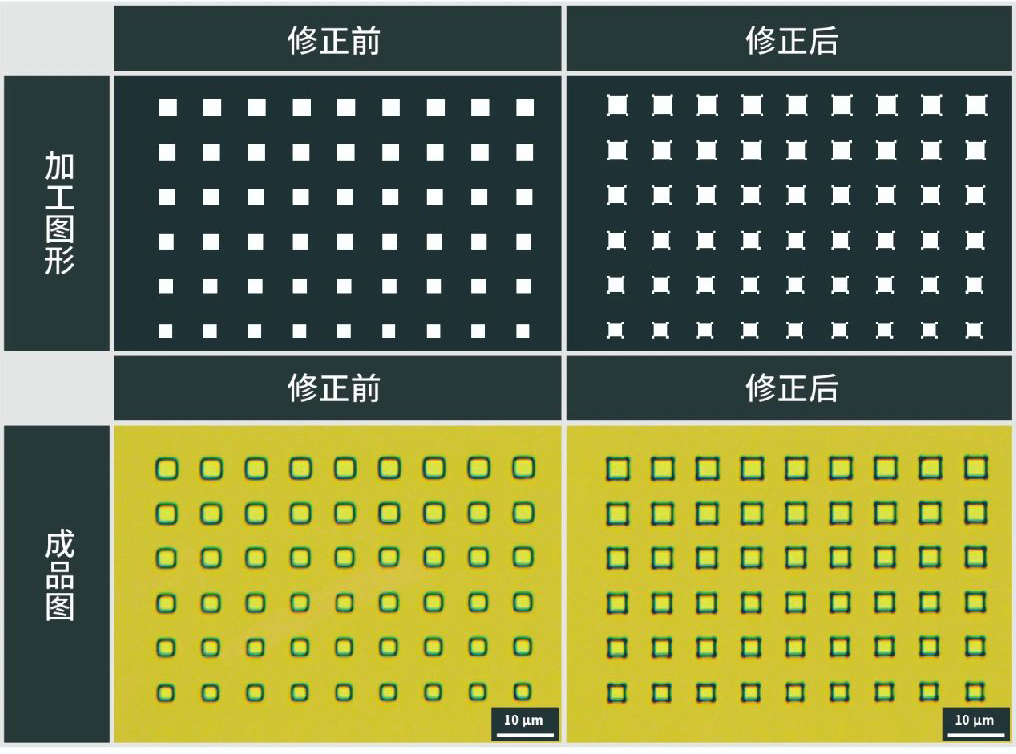
图6方块(外角)修正结果
托托科技OPC技术介绍
托托科技致力于RB-OPC技术(如图 7)。
(1) 设计出测试模型,如光栅、拐角、十字、方格等多种图形;
(2) 同时设计一系列不同属性的边角补偿方式;
(3) 结合光刻工艺(曝光、显影)结果,测量并收集其最佳修正规则数据;
(4) 编写OPC修正规则库,建立图形修正的规则化表格;
(5) 用户通过软件内嵌的OPC技术,可以轻松实现更高品质的光刻作业。

图 7 OPC技术流程

图 8 修正流程
托托科技所提供的OPC修正模块的技术核心,是OPC修正规则库的建立和OPC验证。该模块能够快速自动识别边角、线宽等要素,根据规则数据库对结构进行一定程度的优化和修正,较大程度地确保最终产品的设计精确性以及各种图形的完整呈现。托托科技的无掩模光刻设备内嵌了OPC技术,客户无需进行繁琐的工艺论证及优化,可一键调用我们的数据库,完成修正工作,获得更高品质的光刻结果。
托托科技是一家专注于显微光学加工和显微光学检测领域的高新技术企业,在基于数字微镜器件的无掩模光刻技术领域中进行了数年的深入研究和技术积累,致力于给客户提供最新的光刻技术,实现极致的无掩模版光刻精度。

